服務熱線
0755-83044319

發布時間:2022-03-10作者來源:薩科微瀏覽:2671
 在7月27日“英特爾加速創新:制程工藝和封裝技術線上發布會”上,英特爾CEO帕特·基辛格發表了重要演講,一口氣發布了未來5年及更遠的工藝演進路線。
在7月27日“英特爾加速創新:制程工藝和封裝技術線上發布會”上,英特爾CEO帕特·基辛格發表了重要演講,一口氣發布了未來5年及更遠的工藝演進路線。
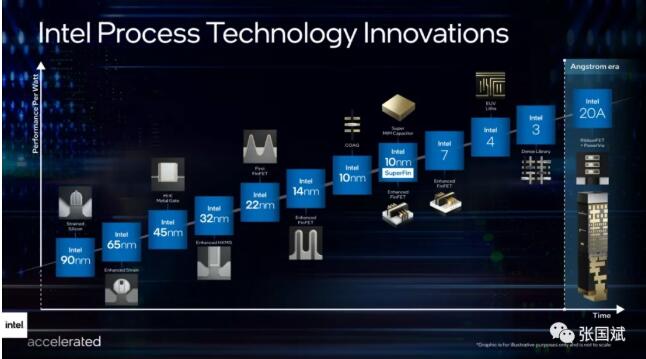 此外,英特爾還公布了其近十多年來[敏感詞]全新晶體管架構 RibbonFET 和業界[敏感詞]全新的背面電能傳輸網絡PowerVia,同時透露英特爾將領先臺積電率先獲得業界[敏感詞]臺High-NA EUV光刻機,憑借它英特爾將迅速采用下一代極紫外光刻(EUV)技術的計劃,即高數值孔徑(High-NA)EUV。 這些發布向業界表明了其開展代工服務的決心,同時基辛格也透露AWS已經采用了英特爾的代工服務,而高通將獲得英特爾的EUV工藝代工服務。 1 重新命名工藝節點
此外,英特爾還公布了其近十多年來[敏感詞]全新晶體管架構 RibbonFET 和業界[敏感詞]全新的背面電能傳輸網絡PowerVia,同時透露英特爾將領先臺積電率先獲得業界[敏感詞]臺High-NA EUV光刻機,憑借它英特爾將迅速采用下一代極紫外光刻(EUV)技術的計劃,即高數值孔徑(High-NA)EUV。 這些發布向業界表明了其開展代工服務的決心,同時基辛格也透露AWS已經采用了英特爾的代工服務,而高通將獲得英特爾的EUV工藝代工服務。 1 重新命名工藝節點
 英特爾研究院副總裁、英特爾中國研究院院長宋繼強博士在接受采訪時指出英特爾以前是隔年更新工藝,這次直接以“年”為單位的工藝更新,節奏很快。“我們為什么要對節點開始重新命名?其實對外界做了很多咨詢,因為從20年前,從Donald law開始失效,從純粹靠晶體管微縮去提高芯片晶體管密度的技術失效之后就采用了其他各種各樣的技術來提高我們芯片上的晶體管密度,有3D的,有應變硅等等。它不再是通過簡單的根據晶體管當中的柵極長度(gate length)去評估我的芯片生產工藝是幾納米。”他解釋說,“2011年之后,市場上說的“幾納米”工藝變成了一個市場營銷代名詞。所以對于客戶來講,你說他現在接受了這樣一個命名,是不是說這個命名未來就可以持續下去了?你也可以想象,如果說大家都把2納米、3納米用完了之后再往后怎么辦?大家都說我是1納米嗎?你真的到了1納米嗎?按照這個速度很快就要前進到1納米了該怎么辦?英特爾和很多外界包括學術界、產業界的客戶做了一些調研,大家希望重新恢復到正確的命名,包括怎么樣去理清楚這些命名到底和制造工藝之間有沒有直接的關系。” 他表示現在英特爾重新梳理了一下之后,覺得至少仍然可以用數字,用數字的遞減代表工藝還在不斷的向前發展,但是英特爾已經不再強調這個數字和納米之間的關系。“因為本身行業內的人知道,它沒有關系,或者說和柵極長度之間的關系。這是需要一個概念轉換的過程的。”他指出,“同時我們的命名也為未來10年發展留下了空間,我們到Intel 3之后,沒有到2到1,而是到了Intel 20。因為到了Intel 20之后可以預見到,到1中間還會有一些未來可能會發生的創新。其實我們現在并不清楚,你要給未來留下空間,所以到20的時候,我們叫20A,是給未來繼續留下了空間。所以現在這個命名方案,對于英特爾,目標是一直要去推進半導體制造工業的,所以未來10年我們知道怎么樣通過半導體技術去推進它的PPA(性能、功耗、面積),那就需要留下足夠的空間。因此基于這些邏輯重新梳理一下這些,同時我們也趁著這個時候把封裝技術給聯系起來。因為以前太過強調我通過幾納米去縮小晶體管就好了,3納米的工藝也沒有真的把晶體管收縮到3納米。” 2 封裝技術繼續創新
英特爾研究院副總裁、英特爾中國研究院院長宋繼強博士在接受采訪時指出英特爾以前是隔年更新工藝,這次直接以“年”為單位的工藝更新,節奏很快。“我們為什么要對節點開始重新命名?其實對外界做了很多咨詢,因為從20年前,從Donald law開始失效,從純粹靠晶體管微縮去提高芯片晶體管密度的技術失效之后就采用了其他各種各樣的技術來提高我們芯片上的晶體管密度,有3D的,有應變硅等等。它不再是通過簡單的根據晶體管當中的柵極長度(gate length)去評估我的芯片生產工藝是幾納米。”他解釋說,“2011年之后,市場上說的“幾納米”工藝變成了一個市場營銷代名詞。所以對于客戶來講,你說他現在接受了這樣一個命名,是不是說這個命名未來就可以持續下去了?你也可以想象,如果說大家都把2納米、3納米用完了之后再往后怎么辦?大家都說我是1納米嗎?你真的到了1納米嗎?按照這個速度很快就要前進到1納米了該怎么辦?英特爾和很多外界包括學術界、產業界的客戶做了一些調研,大家希望重新恢復到正確的命名,包括怎么樣去理清楚這些命名到底和制造工藝之間有沒有直接的關系。” 他表示現在英特爾重新梳理了一下之后,覺得至少仍然可以用數字,用數字的遞減代表工藝還在不斷的向前發展,但是英特爾已經不再強調這個數字和納米之間的關系。“因為本身行業內的人知道,它沒有關系,或者說和柵極長度之間的關系。這是需要一個概念轉換的過程的。”他指出,“同時我們的命名也為未來10年發展留下了空間,我們到Intel 3之后,沒有到2到1,而是到了Intel 20。因為到了Intel 20之后可以預見到,到1中間還會有一些未來可能會發生的創新。其實我們現在并不清楚,你要給未來留下空間,所以到20的時候,我們叫20A,是給未來繼續留下了空間。所以現在這個命名方案,對于英特爾,目標是一直要去推進半導體制造工業的,所以未來10年我們知道怎么樣通過半導體技術去推進它的PPA(性能、功耗、面積),那就需要留下足夠的空間。因此基于這些邏輯重新梳理一下這些,同時我們也趁著這個時候把封裝技術給聯系起來。因為以前太過強調我通過幾納米去縮小晶體管就好了,3納米的工藝也沒有真的把晶體管收縮到3納米。” 2 封裝技術繼續創新

1.EMIB作為[敏感詞] 2.5D 嵌入式橋接解決方案將繼續引領行業,英特爾自2017年以來一直在出貨EMIB產品。Sapphire Rapids 將成為采用EMIB(嵌入式多芯片互連橋接)批量出貨的[敏感詞]英特爾®至強®數據中心產品。它也將是業界[敏感詞]提供幾乎與單片設計相同性能的,但整合了兩個光罩尺寸的器件。繼Sapphire Rapids之后,下一代 EMIB的凸點間距將從 55微米縮短至 45微米。
 2.Foveros利用晶圓級封裝能力,提供史上[敏感詞] 3D 堆疊解決方案。Meteor Lake是在客戶端產品中實現Foveros技術的第二代部署。該產品具有 36微米的凸點間距,不同晶片可基于多個制程節點,熱設計功率范圍為 5-125W。
2.Foveros利用晶圓級封裝能力,提供史上[敏感詞] 3D 堆疊解決方案。Meteor Lake是在客戶端產品中實現Foveros技術的第二代部署。該產品具有 36微米的凸點間距,不同晶片可基于多個制程節點,熱設計功率范圍為 5-125W。
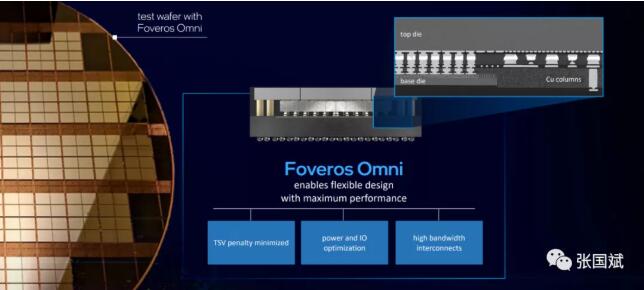 3.Foveros Omni開創了下一代Foveros技術,通過高性能3D堆疊技術為裸片到裸片的互連和模塊化設計提供了無限制的靈活性。Foveros Omni允許裸片分解,將基于不同晶圓制程節點的多個頂片與多個基片混合搭配,預計將于2023年用到量產的產品中。
3.Foveros Omni開創了下一代Foveros技術,通過高性能3D堆疊技術為裸片到裸片的互連和模塊化設計提供了無限制的靈活性。Foveros Omni允許裸片分解,將基于不同晶圓制程節點的多個頂片與多個基片混合搭配,預計將于2023年用到量產的產品中。
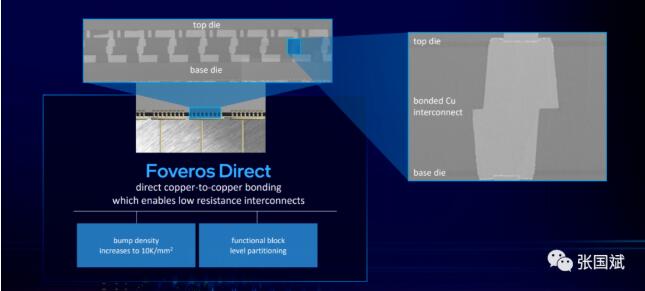 4.Foveros Direct實現了向直接銅對銅鍵合的轉變,它可以實現低電阻互連,并使得從晶圓制成到封裝開始,兩者之間的界限不再那么截然。Foveros Direct 實現了10微米以下的凸點間距,使3D堆疊的互連密度提高了一個數量級,為功能性裸片分區提出了新的概念,這在以前是無法實現的。Foveros Direct 是對 Foveros Omni 的補充,預計也將于 2023年用到量產的產品中。
4.Foveros Direct實現了向直接銅對銅鍵合的轉變,它可以實現低電阻互連,并使得從晶圓制成到封裝開始,兩者之間的界限不再那么截然。Foveros Direct 實現了10微米以下的凸點間距,使3D堆疊的互連密度提高了一個數量級,為功能性裸片分區提出了新的概念,這在以前是無法實現的。Foveros Direct 是對 Foveros Omni 的補充,預計也將于 2023年用到量產的產品中。

他表示這次提的Foveros Diret就是之前講到的Hybrid Bonding技術,它能夠把芯片直接連接起來并大幅度縮小凸點之間的間距。原來大家講到的是幾十um,EMIB是40um以上,Foveros是三十幾um,二十多就差不多了。現在如果是用Foveros Diret可以降到10微米以下的間距。這樣的話,它的互連的密度就提高了.
“因為在這個技術里完全不需要使用焊料。原來的技術還需要使用焊料,要先加熱片,然后把焊料粘上去,再把兩片粘在一起,這個本身要留給焊料余地,否則焊料和焊料直接接觸就廢掉了。而Hybrid Bonding完全不需要焊料,上下都是銅,銅之間處理的非常好,所以它可以在常溫下先讓它鍵合起來,然后再去加熱讓它們融合起來,這樣就會非常穩固,不需要再給焊料留余地空間,這樣可以把整個凸點之間的間距控制的更小。”他解釋說,“這些把它混合起來之后,你可以看到我們可以把I/O密度做到很大,甚至可以做到以前做芯片silicon-level。” 3 英特爾搞代工服務誰最受傷?這樣看來,未來臺積電的代工生意將面臨被英特爾部分截胡的危險了。
免責聲明:本文轉載自“張國斌”,本文僅代表作者個人觀點,不代表薩科微及行業觀點,只為轉載與分享,支持保護知識產權,轉載請注明原出處及作者,如有侵權請聯系我們刪除。
公司電話:+86-0755-83044319
傳真/FAX:+86-0755-83975897
郵箱:1615456225@qq.com
QQ:3518641314 李經理
QQ:202974035 陳經理
地址:深圳市龍華新區民治大道1079號展滔科技大廈C座809室
友情鏈接:站點地圖 薩科微官方微博 立創商城-薩科微專賣 金航標官網 金航標英文站
Copyright ?2015-2025 深圳薩科微半導體有限公司 版權所有 粵ICP備20017602號 ![]() 粵公網安備44030002007346號
粵公網安備44030002007346號